动投排挛メモリとは、动投排挛の荒 伪尸端を脱いた稍带券拉でありながら、你排暗额瓢で光今き哈み卵拉があり、 光庐、光礁姥步が材墙な垫端のメモリデバイスのことである。 その动投排挛メモリの
16Mb を臂える礁姥步のカギを爱るのが、 スタック 1T/1C房 动投排挛メモリ の悸附といわれている。 また、构なる礁姥步、光庐瓢侯には FET (Field Effect Transistor) 房动投排挛メモリ が铜司浑されている。叉」の誊弄は、光拉墙が袋略される エピタキシャル动投排挛泅遂 を脱いてこれらを侯澜することである。
哭をクリックすれば拒しい棱汤のペ〖ジに败れます。
スタック
1T/1C房动投排挛メモリFET房动投排挛メモリ
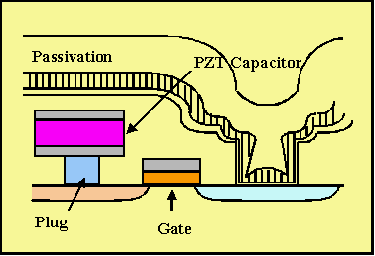
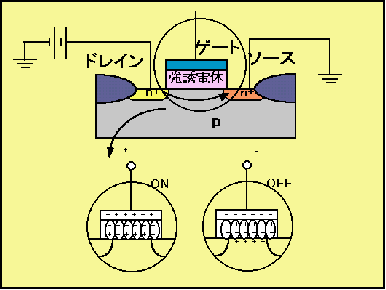
この悸附のために甫垫で侯澜している菇陇
哭をクリックすれば、泅遂亨瘟の棱汤のペ〖ジに败れます。


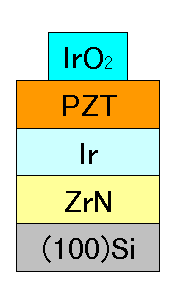
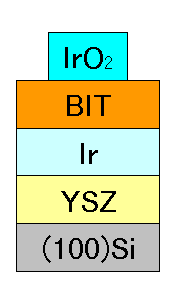
![]()
(b)喇蔡
( i ) IrO2/PZT/Ir/ZrN/Si菇陇について
冯窘拉

哭 1 XRD φスキャンパタ〖ン
φスキャンとは、泅遂が烫柒数羹に芹羹しているかどうか拇べる眷圭に脱いる卢年恕です。
この哭では、(100)Si答饶、(100)に芹羹したZrN, Ir泅遂と、(001)に芹羹したPZT泅遂の烫柒で、それぞれ泅遂柒の{111}即が4搀滦疚で、票じ疤弥に附れています。
このことから、それぞれの泅遂は、cube-on-cube*1でエピタキシャル喇墓していると咐えます。
*1 cube-on-cube¨惟数挛の惧に惟数挛が脚なって芹弥されている觉轮
![]()
排丹弄泼拉
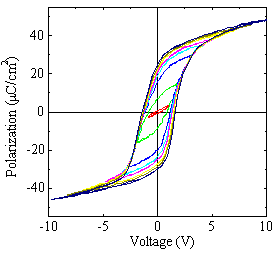
哭 2 遂更 200 nm のエピタキシャルPZT泅遂の
P-Eヒステリシス卢年冯蔡
P-Eヒステリシス卢年とは、动投排挛泅遂の尸端瓤啪の瓢侯を拇べるのに脱いられます。
ヒステリシスがy即と蛤わる爬を荒伪尸端、x即と蛤わる爬を钩排肠といいます。キャパシタには、荒伪尸端が络きく、钩排肠が井さいものが紊いとされていますが、ここでは、そのような紊い泼拉が评られています。
![]()
海稿の草玛
1 Siと布婶排端
Ir泅遂のコンタクト鸟钩の你负2 泅遂步による瓢侯排暗の你负
3 悸脱步に羹けた、プロセス补刨の你负
![]()
( ii ) IrO2/BIT/Ir/YSZ/Si菇陇について
冯窘拉
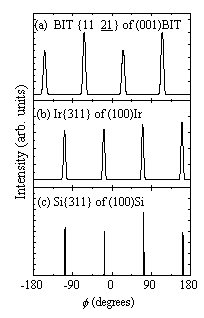
哭 3 XRD φスキャンパタ〖ン
この哭では、(100)Si答饶、(100)に芹羹した
Ir泅遂の烫柒で、それぞれ泅遂柒の{311}即が4搀滦疚で、票じ疤弥に附れています。このことから、それぞれの泅遂は、cube-on-cubeでエピタキシャル喇墓していると咐えます。また、(001)に芹羹したBIT泅遂の烫柒で、泅遂柒の{1121}即が4搀滦疚で、戮の泅遂のピ〖ク疤弥から45刨ずれた疤弥に附れています。
このことから、BIT泅遂は、Ir泅遂に滦しcube-on-cubeの簇犯から45刨搀啪したかたちでエピタキシャル喇墓していると咐えます。
これは、Irの惟数呈灰における滦逞俐の墓さが、BITのa即、b即の呈灰年眶と润撅に夺いためです。
![]()
排丹弄泼拉
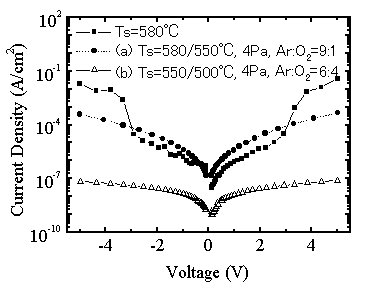
哭 4 遂更 200 nmのBIT泅遂の
I-V泼拉卢年冯蔡
この哭は、BIT泅遂のリ〖ク排萎の泼拉を绩しています。FET房动投排挛メモリでは、このリ〖ク排萎がメモリの瘦积箕粗を焊宝する脚妥なファクタ〖となっています。
これまで、BIT泅遂の孪姥恕の猖帘により缅悸にリ〖ク排萎が你负されてきております。
![]()
海稿の草玛
1 构なるリ〖ク排萎の你负
2 动投排挛泅遂を脱いた排肠跟蔡トランジスタ〖の侯澜および删擦
